Usuari:Mcapdevila/Fotolitografia
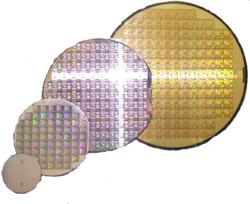
La fotolitografia és un procés emprat en la fabricació de dispositius semiconductors o circuits integrats. El procés consisteix a transferir un patró des d'una fotomàscara (anomenada retícula) a la superfície d'una oblia. El silici, en forma cristal·lina, es processa en la indústria en forma d'oblies. Les oblies s'empren com a substrat litogràfic, però hi ha altres opcions com el vidre, safir, i fins i tot metalls. La fotolitografia (també anomenada "microlitografia" o "nanolitografia") treballa de manera anàloga a la litografia emprada tradicionalment en els treballs de impressió i comparteix alguns principis fonamentals amb els processos fotogràfics.
Processos de la fotolitografia
[modifica]Un cicle típic de procediments en la fotolitografia podria constar dels següents processos:
- Preparació del substrat . Es comença dipositant una capa de metall conductiu de diversos nanòmetres de gruix sobre el substrat.
- Aplicació de les resines fotoresistents . S'aplica sobre la capa metàl·lica una altra capa de resina fotosensible. Sol ser una substància que canvia les seves característiques químiques amb l'exposició a la llum (generalment radiació ultraviolada.
- Introducció al forn (escalfament lleuger). En aquesta etapa es fixen les resines sobre el substrat de silici.
- Exposició a la llum . S'usa una placa (denominada fotomàscara ) amb àrees opaques i transparents amb el patró a imprimir. La fotomàscara es col·loca interposant-se entre la placa preparada i la font lluminosa, d'aquesta manera, s'exposen a la llum, només unes parts de la fotoresina, mentre que altres queden ocultes en la foscor.
La llum que s'utilitza té una longitud d'ona a la zona ultraviolada (UV) de l'espectre. Com més curta la longitud d'ona, major la resolució que es pot aconseguir, de manera que sempre s'han anat buscat fonts de llum (làmpades o làsers) amb menor longitud d'ona. Inicialment es van utilitzar llums de mercuri (Hg), i posteriorment van començar a utilitzar làsers de excímero, amb longituds d'ona més encara més curtes. Actualment s'utilitzen principalment els làsers de KrF, amb la longitud d'ona de 248nm i ARF, amb una longitud d'ona de 193nm, que és el que es coneix com Ultraviolada profund (Deep UV o DUV en anglès)
- Revelat . En aquesta fase, la fotoresistencia està preparada per reaccionar de manera diferent a un atac químic, deixant el patró de la fotomàscara gravat a la placa.
- Introducció al forn (escalfament fort). Es fixen els canvis que la impressió ha realitzat anteriorment.
- Aplicació del àcid nítric o aigua forta . Es netegen les restes de les resines fotorresistentes, deixant l'oblia amb les marques originals de la fotomàscara.

Les sales blanques on es realitzen aquestes operacions solen estar lliures de partícules en suspensió, així com de l'exposició a llums blaves o ultraviolades, per tal d'evitar tant la contaminació del procés com l'exposició indesitjada de les fotoresines. El espectre de llum emprat per a la il·luminació dels processos és de color groc, per evitar qualsevol tipus de reflex.
La litografia s'empra en aquest complex procés d'elaboració, ja que es té un complet control de la mida i dimensions de les parts impreses sobre les oblies de silici, a més de poder traslladar els patrons de la fotomàscara a tota la superfície de l'oblia alhora. Una de les principals desavantatges, d'aquest procediment, són les necessàries dependències d'un substrat, a més el mètode no es pot utilitzar en la generació d'imatges que no són planes. A aquest inconvenient caldria afegir les extremes condicions de neteja requerides quan es tracten les oblies. Quan s'elabora un circuit integrat complex, (per exemple un dispositiu CMOS) l'oblia passa pel cicle unes cinquanta vegades. Per a l'elaboració d'un transistor de capa prima (TFT) el procés de fotolitografia s'executa unes quantes vegades.
Tecnologia
[modifica]Tecnologies en la preparació del substrat
[modifica]Una oblia s'introdueix en un sistema automatitzat de seguiment ("wafertrack"). Aquest tram automatitzat consisteix en un conjunt de robots que manipulen el procés de forma autònoma, de forn/refredament, així com els processos de recobriment/desenvolupament de les unitats. Els robots s'empren per transferir les oblies d'un mòdul a un altre. Les oblies s'escalfaven inicialment en un forn a una temperatura suficient elevada com per eliminar la humitat de la superfície de l'oblia. S'afegeix a l'atmosfera hexa-metil-disilizano (HMDS) amb l'objecte de facilitar l'adhesió de la fotoresina, que és un material polimèric anomenat fotoresistor. Quan s'afegeix la fotoresina es gira la placa perquè es distribueixi homogèniament. La velocitat i acceleració dels moviments de manipulació de la oblia són paràmetres importants d'aquesta fase, ja que són els responsables del gruix i uniformitat de la fotoresina. Les oblies recobertes s'introdueixen en un forn perquè siguin tractades amb temperatures no gaire altes.

La forma més simple d'exposició és una impressió de contacte o de proximitat. Una impressió de contacte s'obté col·locant la fotomàscara en contacte directe amb l'oblia. En una impressió de proximitat existeix gairebé sempre un petit forat entre la fotomàscara i l'oblia. El patró de la fotomàscara s'imprimeix directament sobre l'oblia fotoresistente en ambdós casos. La resolució de la "imatge" obtinguda ve donada per la arrel quadrada del producte de la longitud d'ona i la distància de separació. D'aquesta manera, la impressió de contacte, ja que té una separació pràcticament nul·la ofereix una millor resolució.
Tecnologies d'il·luminació
[modifica]El mètode més corrent emprat en l'actualitat en fotolitografia és la projecció. El patró de la màscara és projectat directament sobre la superfície de l'oblia mitjançant una màquina anomenada escàner o stepper. Les funcionalitats del stepper/scanner són similars a les d'un projector. La llum procedeix d'una llum d'arc de mercuri o d'un làser excímero focalitzat a través d'un complex sistema de lents sobre la "màscara" (anomenada també reticle) , que conté la imatge desitjada. La llum passa a través de la màscara i es focalitza sobre la superfície de l'oblia mitjançant un sistema de lents de reducció. El sistema de reducció pot variar segons el disseny però sol ser bastant usual un ordre de magnitud en la reducció de 4X-5X.
Quan la imatge és projectada sobre l'oblia, el material fotoresistente actua només a certs rangs de longituds d'ona, el que causa que les regions exposades canviïn les seves propietats fisicoquímiques. Generalment es canvia l'acidesa del substrat de la resina, fent que sigui més àcid o alcalí que la part no exposada. Si la regió exposada és més àcida es diu que és una resina positiva, mentre que és negativa si és més alcalina. La resistència és "revelada" per exposició a una solució alcalina que elimina les parts exposades de la resina (en el cas d'una fotoresistencia positiva) o no exposada (fotoresistencia negativa). Aquest procés té lloc després que l'oblia s'hagi transferit del sistema d'exposició al wafertrack.
Les dissolucions fixadores emprades corresponen a dissolucions amb hidròxid de sodi (NaOH). No obstant això el sodi és considerat com un component contaminant extremadament indesitjable en la indústria de fabricació dels components MOSFET, pel fet que afecta negativament les propietats aïllants de les portes, en seu lloc s'empra hidròxid de tetrametilo d'amoni (TMAH) que està lliure de sodi.
La capacitat per imprimir imatges clares depèn de la longitud d'ona emprada en la projecció. Els fonts de llum actuals empren longituds d'ona en el rang del ultraviolat profund (DUV), és a dir, de longituds d'ona que varien entre els 248 i 193 nanòmetres. Aquestes longituds d'ona permeten una capacitat de discerniment de detalls de com a màxim 50 nanòmetres. Per reduir aquest límit d'impressió per sota dels 50 nm es necessiten d'altres tècniques basades en llum de 193 nm, així com tècniques d'immersió en líquids (litografia per immersió).
Les eines que empren longituds d'ona de 157 nm DUV actuen d'una manera similar als sistemes actuals d'exposició. el 2006 l'empresa IBM va aconseguir litografiar detalls menors de 30 nm. [1] Altres tècniques emprades avui dia cauen dins el camp de la nanolitografia.
Vegeu també
[modifica]Referències
[modifica]- ↑ Hand, Aaron. High-Index Lenses Push Immersion Beyond 32 nm.
Enllaços externs
[modifica]- Semiconductor lithography Visió general sobre els processos litogràfics en la indústria dels semiconductors, (en anglès)
- Optical·lithography Introduction Pàgina d'IBM amb articles sobre litografia, (en anglès)
- Immersion lithography Article] On es mostra com s'incrementa la profunditat de focus mitjançant la litografia d'immersió (en anglès)
- Photolithography Article sobre la litografia de contacte, proximitat i projecció (en anglès)
